ТУННЕЛЬНЫЙ ДИОД
двухэлектродный
Рис. 1. Энергетические диаграммы электронно-дырочного
Однако при дальнейшем увеличении напряжения
Рис. 2. Вольтамперные характеристики
Первый Т. д. был изготовлен в 1957
Лит.: Esaki L., New phenomenon
А
Б
В
Г
Д
Е
Ё
Ж
З
И
Й
К
Л
М
Н
О
П
Р
С
Т
У
Ф
Х
Ц
Ч
Ш
Щ
Ъ
Ы
Ь
Э
Ю
Я
электронный прибор на основе полупроводникового кристалла, в к-ром имеется
очень узкий потенциальный барьер, препятствующий движению электронов; разновидность
полупроводникового диода. Вид вольтамперной характеристики (ВАХ)
Т. д. определяется гл. обр. кван-товомеханич. процессом туннелирования
(см. Туннельный эффект), благодаря к-рому электроны проникают сквозь
барьер из одной разрешённой области энергии в другую. Изобретение Т. д.
впервые убедительно продемонстрировало существование процессов туннелирования
в твёрдых телах. Создание Т. д. стало возможно в результате прогресса в
полупроводниковой технологии, позволившего создавать полупроводниковые
материалы с достаточно строго заданными электронными свойствами. Путём
легирования полупроводника большим количеством определённых примесей удалось
достичь очень высокой плотности дырок и электронов в р- и n-областях,
сохранив при этом резкий переход от одной области к другой (см. Электронно-дырочный
переход). Ввиду малой ширины перехода (50-150 А) и достаточно
высокой концентрации легирующей примеси в кристалле, в электрич. токе через
Т. д. доминируют туннелирующие электроны. На рис. 1 приведены упрощённые
энергетич. диаграммы для таких р - n-переходов при четырёх
различных напряжениях смещения U. При увеличении напряжения смещения
до U
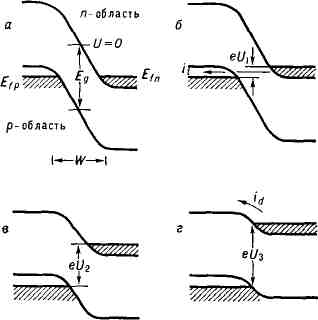
перехода туннельного диода при различных напряжениях смещения (О<U
E
E
е - заряд электрона; i
и диффузионный токи.
(напр., до значения U
в n-области и валентная зона в р-области расходятся, и ввиду сокращения
числа разрешённых уровней энергии для туннельного перехода ток уменьшается
- в результате Т. д. переходит в состояние с отрицательным сопротивлением.
При напряжении, достигшем или превысившем U
1, г), как и в случае обычного р - n-перехода, будет
доминировать нормальный диффузионный (или тепловой)
(ВАХ) туннельных диодов на основе Ge (1), GaSb (2), Si (3) и GaAs (4):
U - напряжение смещения на туннельном диоде; 1/1
тока через диод к току в максимуме ВАХ.

из германия; однако вскоре после этого были выявлены др. полупроводниковые
материалы, пригодные для получения Т. д.: Si, InSb, GaAs, InAs, PbTe, GaSb,
SiC и др. На рис. 2 приведены ВАХ ряда Т. д. В силу того что Т. д. в нек-ром
интервале напряжений смещения имеют отрицательное дифференциальное сопротивление
и обладают очень малой инерционностью, их применяют в качестве активных
элементов в высокочастотных усилителях электрических колебаний, генераторах
и переключающих устройствах. Л. Эсаки.
От редакции. Т. д. был предложен
в 1957 лауреатом Нобелевской пр. Л. Эсаки, поэтому Т. д. называют
также диодом Эсаки
in narrow germanium p-n junctions, "Physical Review", 1958, v. 109, № 2;
его же Long journey into tunnelling, "Reviews of modern Physics", 1974,
v. 46, № 2.