ПЛАНАРНАЯ ТЕХНОЛОГИЯ
планарный
процесс (англ. planar, от лат. planus - плоский, ровный), первоначально
- совокупность технологич. операций, проводимых для получения полупроводниковых
(ПП) приборов с электронно-дырочными переходами, границы к-рых выходят
на одну и ту же плоскую поверхность ПП пластины и находятся под слоем защитного
диэлектрич. покрытия; в современном, более широком смысле - совокупность
технологич. операций, проводимых для получения практически любых ПП приборов
и интегральных схем, в т. ч. и таких, у к-рых границы электронно-дырочных
переходов не выходят на одну плоскую поверхность. Термины "П. т." и "планарный
прибор" появились в 1959, когда амер. фирмой "Фэрчайлд" (Fairchild) были
созданы первые планарные кремниевые транзисторы.
Осн. технологич. операции при изготовлении
По мере своего развития П. т. включила
Гл. достоинство П. т., послужившее причиной
Лит.: Кремниевые планарные транзисторы,
Е. З. Мазель.
А
Б
В
Г
Д
Е
Ё
Ж
З
И
Й
К
Л
М
Н
О
П
Р
С
Т
У
Ф
Х
Ц
Ч
Ш
Щ
Ъ
Ы
Ь
Э
Ю
Я
классич. планарного кремниевого транзистора с n-p-n-переходами выполняются
в след. последовательности. На отшлифованной, а затем отполированной, тщательно
очищенной плоской поверхности пластины из монокристаллич. кремния с электропроводностью
n-типа (рис., а)термич. окислением в сухом или влажном кислороде создают
слой двуокиси кремния (SiO2) толщиной от неск. десятых до 1,0-1,5
мкм
(рис.,
6).
Далее
производят фотолитографич. обработку этого слоя (см. Фотолитография):
на
окисленную поверхность кремния наносят слой фоторезиста, чувствительного
к ультрафиолетовому излучению; пластину с высушенным слоем фоторезиста
помещают под шаблон - стеклянную пластину с рисунком, в заданных местах
прозрачным для ультрафиолетового излучения; после обработки излучением
фоторезист в тех местах, под к-рыми должен сохраняться слой SiO
и удаляют травлением обнажившийся слой SiO
проводят диффузию бора (акцепторной примеси) для создания в материале
исходной пластины (коллекторная область) базовой области с электропроводностью
р-типа. Т. к. диффузия одновременно идёт и перпендикулярно поверхности
пластины, и параллельно ей, т. е. под края окисной плёнки, то границы электронно-дырочного
перехода между коллекторной и базовой областями, выходящие на поверхность
пластины, оказываются закрытыми слоем SiO
подвергают окислению и повторно производят фотолитографии, обработку (рис.,
д)с
целью
создания эмиттерной области с электропроводностью n-типа диффузией
фосфора (донорной примеси) в заданные участки базовой области. При этом
границы электронно-дырочных переходов между эмиттерной и базовой областями
оказываются также закрытыми слоем SiO
После
диффузии доноров или одновременно с ней проводят третье окисление и над
эмиттерной областью создают слой чистой SiO
над эмиттерной и базовой областями в плёнке окисла отверстия для контактов
к этим областям (рис.,
ж). Контакты создают нанесением тонкой металлической
плёнки (обычно Аl; рис., э). Контакт к коллекторной области . осуществляют
путём металлизации нижней поверхности исходной пластины. Пластину кремния
разрезают на отд. кристаллы, каждый из к-рых имеет транзисторную структуру.
Наконец, каждый кристалл помещают в корпус и герметизируют последний.
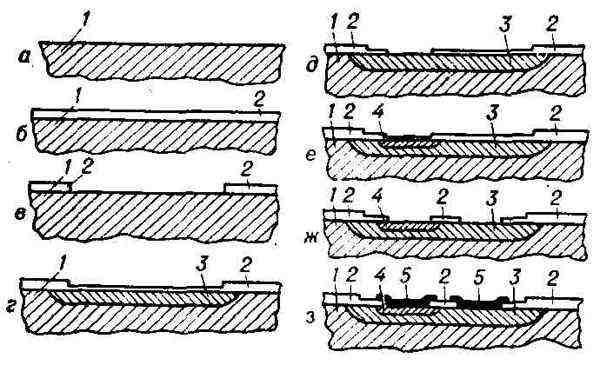
Стадии изготовления планарного транзистора:
а - исходная пластина; 6 - после первого окисления; в - после первой фотолитографической
обработки; г - после создания базовой области и второго окисления; д -
после второй фотолитографической обработки; в - после создания эмиттерной
области и третьего окисления; ж - после третьей фотолитографической обработки;
з - после металлизации; 1 - исходный кремний с электропроводностью n-типа;
2 - маскирующая плёнка двуокиси кремния; 3 - базовая область; 4 - эмиттерная
область; 5 -металлическая плёнка (контакты).
в себя ряд новых процессов. В качестве материала защитных плёнок используют
не только SiO
среде) распыление кремния и др. процессы. Для селективного удаления защитной
диэлектрич. плёнки, помимо обычной оптич. фотолитографии, применяется обработка
электронным лучом (т. н. электронолитография). Для легирования кремния,
кроме диффузии, используют ионное внедрение донорных и акцепторных
примесей. Получило распространение сочетание методов П. т. с технологией
эпитаксиального выращивания (см. Эпитаксия). В результате такого
сочетания создан широкий класс разнообразных планарно-эпитаксиальных ПП
приборов. Появилась возможность получать стойкие защитные диэлектрич. плёнки
не только на кремнии, но и на других ПП материалах. В результате были созданы
планарные ПП приборы на основе германия и арсенида галлия. В качестве легирующих
примесей в П. т. используют не только бор и фосфор, но также др. элементы
третьей и пятой групп периодич. системы элементов Д. И. Менделеева.
её распространения в полупроводниковой электронике, заключается
в возможности использования её как метода группового изготовления ПП приборов,
что повышает производительность труда и процент выхода годных приборов,
позволяет уменьшить разброс их параметров. Применение в П. т. таких прецизионных
процессов, как фотолитография, диффузия, ионное внедрение, даёт возможность
очень точно задавать размеры и свойства легируемых областей и в результате
получать параметры и их сочетания, недостижимые при др. методах изготовления
ПП приборов. Защитные диэлектрич. плёнки, закрывающие выход электронно-дырочных
переходов на поверхность ПП материала, позволяют создавать приборы со стабильными
характеристиками, мало меняющимися во времени. Этому способствует также
ряд спец. мер: поверхность пластин перед нанесением защитной плёнки тщательно
очищают, при создании защитных плёнок используют особо чистые исходные
вещества (напр., бидистиллированную воду, к-рая после последней дистилляции
не
контактирует с внеш. средой) и т. д.
под ред. Я. А. Федотова, М., 1973; Пресс Ф. П., Планарная технология
кремниевых приборов, М.,1974.